オーバークロッカーはココまでやるのか。
ソルダリングこそ命?
ここ最近、 NieR:Automataの話題かRyzenの話題しか書いていないが、自分の中ではそれぐらいしか話題がないから困る。
と言うわけで、今日もRyzenの話を中心にする。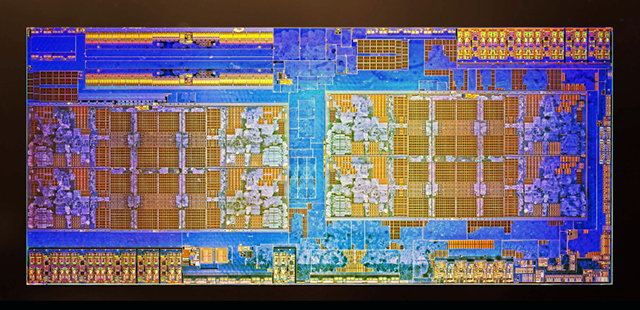 先日発表、発売となったRyzen 7シリーズだが、ヒートスプレッダの中はソルダリングされている事がわかっている。
先日発表、発売となったRyzen 7シリーズだが、ヒートスプレッダの中はソルダリングされている事がわかっている。
ここ最近、Intelコアはココがソルダリングではなく、高効率グリスによって熱を逃がしている製品ばかりで、一部ハイエンド製品であるLGA2011のCore i7シリーズのみソルダリングという手法を採っている。
ソルダリング…いわゆるハンダ付けは、流体金属による熱伝導によってヒートスプレッダに熱を逃がす仕組みであるため、オーバークロックなどによる高熱を効率良く冷却するのに向いている。
ところがそれをIntelは高効率のグリスによってヒートスプレッダまで熱を逃がすという方法にしたため、SkyLakeやKaby Lakeでは思ったほどの排熱効果が得られず、オーバークロックに不向きという状態だった。
その為、一部のオーバークロッカーの間では殻割りと呼ばれる、ヒートスプレッダを外す行為が行われ、コアに直接クーラーを装着してオーバークロックを行うという方法が行われたりもした。
だが、この殻割りは非常に危険な行為で、CPUコアの周囲にあるチップまで削ってしまったり、コアそのものを傷つけてしまったりと事故も多く、専用の殻割り製品が発売されたりと、Intelがソルダリングにしてくれていればそこまでしなくてもよい事例が多発した。
その影響があったからなのか、Ryzen 7は最初からソルダリングというハンダ付けによるヒートスプレッダ装着が行われていて、元々熱効率が良い商品として発売されているという。
熱伝導率
このソルダリングは、確かにグリスから比べれば非常に高い熱伝導率をもつ手法だが、ハンダそのものの熱伝導率も使用するハンダによって異なる為、ソルダリングだから安心というわけではない。
実際、IntelのLGA2011のCore i7シリーズにしようされているソルダリングは、熱伝導率81.8W/(m・K)のインジウムというものが使われていて、ヒートスプレッダに使われる胴の398W/(m・K)とは比較にならないくらい熱伝導率が低い。
実際Ryzenに使われているソルダリングの熱伝導率は不明だが、Intelコア時は殻割りで温度を最大6℃、平均で4℃下げられたのに対し、Ryzenは温度で最大3℃、平均で1℃しか殻割りしても変化がなかったというから、元々のソルダリングの熱伝導率はIntel製よりはずっと良いという事が言えそうである。
つまり、大きなリスクを背負わずとも、Ryzenの場合は熱伝導率から冷却さえしっかり行う事ができれば比較的容易にオーバークロックが可能という事になる。
もちろんオーバークロックをしなくても、かなりの性能を叩き出すRyzenだが、オーバークロック耐性が高いという事は、低価格版が出たときに有利に働く。
今後発売されるであろうRyzen 5/3シリーズでも同じようにソルダリングによる提供になれば、1万円台のコアがIntelのCore i7シリーズと肩を並べる性能を叩き出すかもしれない。
不満がでるのはレーン数のみ?
今のRyzenでの不満は、ほとんどの人はほぼないのではないかと思うが、仮にあったとしてPCI Expressのレーン数だけではないかと思う。
一応、Ryzenそのものが持つレーン数は20本であり、これにチップセットがもつレーン数を足していく事になるのだが、総計するとKaby Lakeには及ばない。AMDとしては今回のRyzen対応チップセットであるX370などはがんばった製品と言えるが、このあたりはやはりまだIntelの方がこなれていると言える。
但し、Ryzenそのものの性能は現時点でIntelをかなり脅かす事ができた製品であるため、今後のIntel製品へと大きく影響を与えたことは間違いない。
正直、今後こなれてくるであろうRyzen関係のUEFIやソフトウェアを考えると、この性能がまだ伸びるのかと期待せずにはいられない。
PCI Expressのレーン数に4レーンほどの差がIntelとあったとしても、それに直接影響を受ける人はそんなに多くはない事を考えれば、今の時点で将来有望視できるコアであると断言できそうである。
ただ、このPCI Expressのレーン数とそれを割り当てられているPCI Expressのスロットに関しては、マザーボードの仕様をより理解しないと、ビデオカード等の接続で性能を最大限に引き出す事ができないので要注意だ。
まぁ、この問題はAMDだけでなくIntelでも同様である事に違いは無いのだが。




